按封装外形和引脚结构分类(最直观的分类方式)
这是最常用、最基础的分类方法,主要根据封装的形状和引脚在封装主体上的位置来划分。
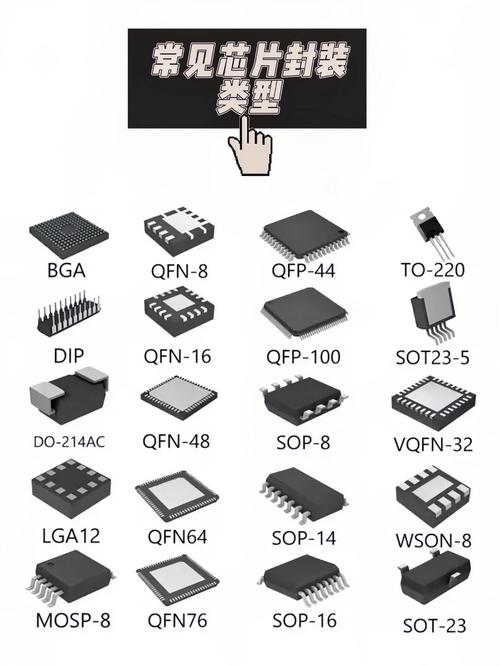
无引线封装
这类封装没有传统的金属引脚,焊端直接封装在封装体的底部,直接贴装在PCB的焊盘上,其主要优点是尺寸小、寄生电感/电容小、高频性能好。
-
CSP (Chip Scale Package, 芯片级封装)
- 特点:封装尺寸与裸芯片尺寸非常接近(通常不超过裸芯片的1.2倍倍),是当前实现电子产品小型化的关键技术。
- 常见类型:
- BGA (Ball Grid Array, 球栅阵列):焊端为分布在封装底部的球形焊料矩阵,虽然BGA尺寸比CSP稍大,但常被广义地归入CSP范畴。
- μBGA (Micro BGA):比标准BGA更小。
- Flip Chip (倒装芯片):芯片有源面朝下,通过凸点直接与基板连接,是CSP的一种高级形式。
- WLCSP (Wafer Level Chip Package, 晶圆级封装):在整片晶圆上进行封装和切割,封装成本极低,尺寸最小,性能最优。
-
LCC (Leadless Chip Carrier, 无引线芯片载体)
- 特点:四周有金属焊端,但没有引脚,外形类似DIP但更小,常见于一些逻辑芯片、混合电路等。
有引线封装
这类封装有从封装主体伸出的金属引线,通过引脚与PCB连接。

-
SOP (Small Outline Package, 小外形封装)
- 特点:引脚从封装两侧引出,呈“鸥翼型”或“J型”,是应用最广泛的封装之一。
- 常见变体:
- SOJ (Small Outline J-lead Package, J型引脚小外形封装):引脚呈J型弯曲,贴装后不易损坏,常见于内存条。
- SSOP (Shrink SOP, 缩小型小外形封装):比标准SOP更小,引脚更密。
- TSSOP (Thin SSOP, 超薄缩小型小外形封装):在SSOP基础上进一步减小厚度和尺寸。
- SOT (Small Outline Transistor, 小外形晶体管):主要用于晶体管、稳压器、运放等3-6个引脚的器件。
-
QFP (Quad Flat Package, 四侧引脚扁平封装)
- 特点:引脚从封装的四个侧面引出,呈“鸥翼型”或“J型”,引脚数量多(通常从几十到几百个),适用于大规模集成电路。
- 常见变体:
- TQFP (Thin QFP, 薄型QFP):厚度比标准QFP更薄。
- LQFP (Low-profile QFP, 超薄QFP):比TQFP更薄,通常用于对高度敏感的设备。
- VQFP (Very thin QFP, 极薄QFP):极致的薄型封装。
-
PLCC (Plastic Leaded Chip Carrier, 塑料有引线芯片载体)
- 特点:引脚呈“J型”从封装底部引出并向内弯曲,插入PCB的对应插座中,也可进行表面贴装,特点是引脚不易变形,易于检测和更换,常用于可编程逻辑器件,如CPLD、FPGA。
-
DIP (Dual In-line Package, 双列直插式封装)
 (图片来源网络,侵删)
(图片来源网络,侵删)- 特点:虽然DIP是传统的通孔插装封装,但现在也有其表面贴装版本(称为 SMD DIP 或 SOP 的早期形态),引脚从两侧引出,呈直线型,在SMD技术普及前非常流行,现在主要用于一些老式电路或需要插拔的场合。
按安装方式分类
这是从生产工艺角度进行的分类,决定了元器件如何“站立”在PCB上。
单面安装
元器件仅安装在PCB的一面,这是最简单的安装方式,成本最低,适用于对成本敏感、密度要求不高的产品。
双面安装
元器件安装在PCB的两面,这是目前最主流的生产方式,可以大大提高PCB的组装密度,先安装一面,过回流焊;再翻转安装另一面,再过回流焊或波峰焊。
混合安装
在同一块PCB上,既有SMD元件,也有传统的THD(通孔插装)元件,这种设计在某些特殊应用中是必要的,例如需要承受大电流或机械应力的连接器、大功率开关等,生产工艺相对复杂,通常需要先贴装后插装,再进行一次波峰焊。
按集成度分类
这个维度反映了封装内部芯片的复杂程度。
单芯片封装
一个封装内只封装一个独立的芯片,这是绝大多数元器件(如电阻、电容、单个逻辑门、单片机等)的形式。
多芯片封装
在一个封装内集成两个或多个芯片,这是实现系统级封装的关键技术,可以减小体积、降低功耗、提高信号传输速度。
- 常见类型:
- SiP (System in Package, 系统级封装):将不同功能、不同工艺的芯片(处理器、内存、射频芯片等)集成在一个封装内,形成一个微小的系统。
- PoP (Package on Package, 堆叠封装):将多个芯片在垂直方向上堆叠起来,例如将内存芯片堆叠在处理器芯片之上,是智能手机等移动设备中实现高内存容量的常用技术。
按特殊功能或材料分类
这类封装是为了满足特定需求而设计的。
热增强型封装
针对大功率器件(如CPU、GPU、功率放大器、LED等)设计,通过特殊结构(如散热片、热通孔、金属基板)将芯片产生的热量高效地传导到PCB或外部散热器上。
- 常见类型:
- QFN (Quad Flat No-lead Package, 四侧无引脚扁平封装):底部中央有一个大面积的散热焊盘,直接贴在PCB的铜箔上散热,非常高效。
- DFN (Dual Flat No-lead Package, 双侧无引脚扁平封装):QFN的双侧版本。
- 带散热片的BGA:在封装顶部集成了金属散热片。
高频/射频封装
专为无线通信、雷达等高频应用设计,通过优化封装结构、使用特殊材料(如低介常数基板)来减少信号损耗和串扰。
- 常见类型:
- LFSP (Low-profile Flat Package):一种超薄、低引脚电感的封装。
- 各种专为RF设计的QFN、WLCSP封装。
敏感环境封装
用于汽车电子、航空航天、工业控制等对可靠性要求极高的领域,能够抵抗高温、高湿、振动、冲击等恶劣环境。
- 常见类型:
- AEC-Q 认证的封装(特别是AEC-Q100用于芯片,对应的封装也需满足车规级要求)。
- 增强型BGA/eBGA:具有更好的散热和机械可靠性。
| 分类维度 | 主要类别 | 特点与应用 |
|---|---|---|
| 外形/引脚 | 无引线 (CSP, WLCSP) | 小尺寸,高性能,手机、可穿戴设备 |
| 有引线 (SOP, QFP, PLCC) | 引脚多,应用广泛,逻辑、存储、模拟电路 | |
| 安装方式 | 单面/双面/混合 | 决定PCB组装密度和复杂度,生产流程设计 |
| 集成度 | 单芯片/多芯片 | SiP, PoP 实现系统级集成,提升性能、减小体积 |
| 特殊功能 | 热增强/高频/车规 | 解决散热、信号传输、可靠性等特定问题 |
SMD封装技术是一个不断发展的领域,新的封装形式(如2.5D/3D封装、硅通孔TSV技术等)仍在不断涌现,以满足未来电子产品更极致的需求,选择合适的封装,需要在性能、尺寸、成本、散热和可制造性之间进行综合权衡。