一句话概括
WLP (Wafer-Level Package),即晶圆级封装,是一种先进的半导体封装技术,它的核心特点是:在制造好的、尚未切割的晶圆上直接进行封装和测试,最后才将晶圆切割成单个独立的芯片。
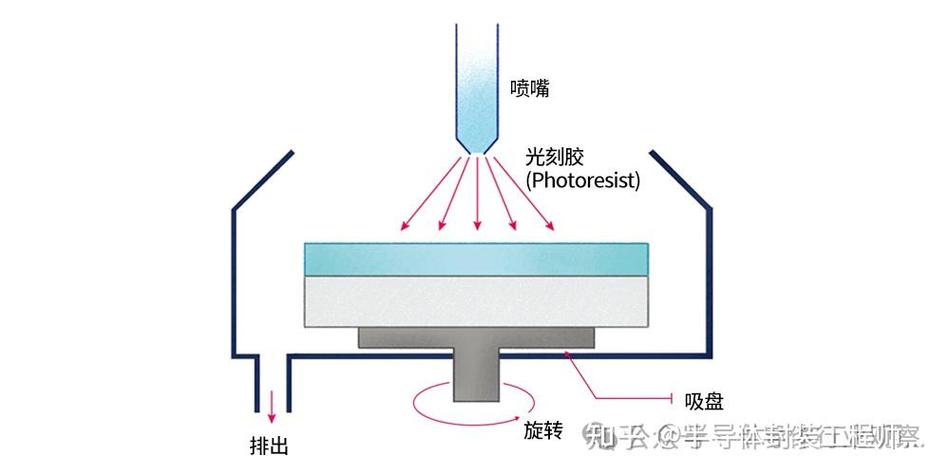
这与传统封装技术(如先切割晶圆,再对单个芯片进行封装)形成了鲜明对比。
WLP 的工作流程(与传统封装对比)
为了更好地理解,我们先看看传统封装和 WLP 的流程差异:
| 步骤 | 传统封装 | 晶圆级封装 |
|---|---|---|
| 晶圆制造 | 在晶圆上制造出大量裸片 | 在晶圆上制造出大量裸片 |
| 封装 | 切割晶圆成单个裸片 → 对单个裸片进行封装(如贴底座、引线键合、塑封等) | 直接在整片晶圆上进行封装(如再布线层、底部填充、塑封等) |
| 测试 | 封装完成后对单个芯片进行测试 | 封装完成后对整片晶圆进行测试 |
| 切割 | 无需再切割 | 将封装好的晶圆切割成单个独立的 WLP 芯片 |
| 分拣 | 将测试好的芯片分拣 | 将测试好的芯片分拣 |
传统封装是“先切后封”,而 WLP 是“先封后切”。
WLP 的主要特点和优势
WLP 技术之所以备受青睐,主要得益于其独特的优势:

-
尺寸小、厚度薄
- 尺寸小:WLP 的封装尺寸几乎等于裸片本身的大小,没有传统封装的“封装体”部分,因此可以实现极高的封装密度。
- 厚度薄:整个封装过程在晶圆表面进行,所以最终产品的厚度可以做到非常薄,通常小于 1 毫米,非常适合空间受限的设备。
-
优异的电学性能
- 由于封装引脚(称为 Solder Balls,焊球)直接制作在芯片表面,并且距离极近,信号传输路径非常短。
- 这大大减小了电感和寄生电容,从而提高了信号传输速度和频率,降低了功耗。
-
极高的生产效率和低成本
- 批量处理:WLP 是在整片晶圆上同时进行封装和测试,而不是一个一个地处理,生产效率极高。
- 减少工序:省去了传统封装中单芯片操作、引线键合等复杂步骤,简化了流程。
- 成本效益:虽然前期设备投入高,但由于高效率和材料利用率(如晶圆边缘的浪费更少),单位芯片的封装成本可以做到非常低。
-
优良的散热性能
 (图片来源网络,侵删)
(图片来源网络,侵删)芯片产生的热量可以直接通过焊球和封装基板快速传导出去,散热路径短,散热效率高。
WLP 的主要缺点和挑战
尽管优势明显,WLP 也有其固有的挑战:
-
应力问题
- 封装材料和芯片材料的热膨胀系数不同,在温度变化时会产生应力,可能导致芯片损坏,特别是对于较大的芯片。
- 解决方案:通常会采用 Redistribution Layer (RDL),即再布线层,来重新分布焊球的位置,缓解应力,并连接到芯片的焊盘上。
-
测试和修复困难
由于焊球在芯片底部,封装后很难像传统封装那样进行直接的功能测试和修复(如激光修复),测试和修复必须在封装前的晶圆级进行,对测试设备要求高。
-
对尺寸和重量敏感
由于没有传统封装的“保护体”,WLP 芯片非常薄且脆弱,在后续的电路板组装和贴片过程中容易受到应力影响而损坏,需要特殊的工艺和设备。
-
I/O 数量限制
对于需要大量 I/O(输入/输出引脚)的复杂芯片,在有限的芯片面积内布置足够多的焊球是一个挑战。
WLP 的主要类型
为了克服上述挑战,WLP 技术也发展出了多种形式:
-
标准 WLP
- 最基础的 WLP,焊球直接制作在芯片的 I/O 焊盘上。
- 缺点:I/O 数量受限于芯片尺寸,且芯片尺寸必须大于封装尺寸(因为有边缘环)。
-
扇入型 WLP
- 焊球直接分布在芯片表面的 I/O 焊盘之间(“扇入”到芯片内部)。
- 优点:封装尺寸最小,接近芯片尺寸。
- 缺点:I/O 数量仍然受限于芯片尺寸,不适合高 I/O 数的芯片。
-
扇出型 WLP
- 这是目前最主流和最具发展前景的 WLP 技术。
- 流程:在芯片周围先塑封一层树脂,然后在树脂上制作 RDL(再布线层),最后在 RDL 上布置焊球。
- 优点:
- I/O 数量多:焊球可以分布在芯片外部的 RDL 上,大大增加了 I/O 数量。
- 尺寸更灵活:芯片尺寸可以小于封装尺寸。
- 性能更好:RDL 层可以优化信号和电源分配。
- 代表厂商:TSMC 的 InFO (Integrated Fan-Out) 技术,苹果 A 系列处理器大量采用此技术封装。
应用领域
由于其小尺寸、高性能和低成本的特点,WLP 技术被广泛应用于各种消费电子产品和移动设备中:
- 智能手机和平板电脑:处理器、射频模块、传感器、电源管理芯片等。
- 可穿戴设备:智能手表、无线耳机、健康监测设备等,对尺寸和功耗要求极高。
- 物联网 设备:各种智能传感器和微型控制器。
- 其他:数码相机、内存卡、Wi-Fi/蓝牙模块等。
WLP (晶圆级封装) 是一项革命性的封装技术,它通过“先封后切”的流程,实现了更小、更薄、更快、更便宜的芯片封装,虽然在应力、测试和 I/O 数量方面存在挑战,但以 扇出型 WLP 为代表的技术演进正在不断克服这些困难,使其成为推动移动设备和物联网小型化、高性能化的关键技术之一,可以说,现代智能手机内部的大部分芯片,都或多或少地应用了 WLP 技术。











